2024年05月31日 19:00
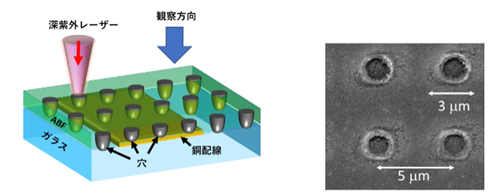
東京大学、味の素ファインテクノ、三菱電機、スペクトロニクスは、次世代の半導体製造「後工程」に必要な、パッケージ基板への3マイクロメートルの極微細レーザー穴あけ加工技術を開発した。
近年、EUV露光技術の発展により半導体チップの微細化が進み、チップの電極間隔も小さくなってきている。それに伴い、チップを受ける側のパッケージ基板の配線も微細化。基板は多層構造となっており、層間の電気信号は絶縁層にあけられた微小な穴を通して結合される。現在は40マイクロメートル程度の穴をレーザーであけて金属メッキを施すことで層間配線を行っているが、チップの微細化に伴い将来パッケージ基板の穴径において5マイクロメートル以下の微細化が必要。
しかしながら現在用いられているレーザー加工技術では、レーザーや光学系の特性で小さい径に集光することが困難であり、また高いアスペクト比の穴あけ加工はできない。また、これに対応する微細穴あけ加工に適した薄い絶縁層も必要だった。
この度、本研究開発チームでは4法人が技術を持ち寄ることにより、これらの課題を解決。半導体向けの層間絶縁体として極めて高いシェアを占める味の素ビルドアップフィルム(R)(ABF)に、3マイクロメートルという超微細穴あけ加工を実現した。
既存技術より一桁小さい穴あけ加工技術を確立することで、より高密度な基板間配線が実現。今後、生成AI等に必要なハイパフォーマンスコンピュータやデータセンター用のチップレットの発展に役立つことが期待される。








