2025年08月08日 15:35
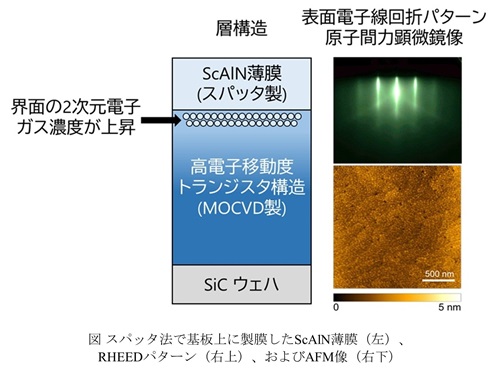
東京理科大学の研究グループは、スパッタ法を用いて、窒化スカンジウムアルミニウム(ScAlN)薄膜を高品質で作製することに成功した。これにより、小型で高性能な次世代トランジスタの開発に大きく貢献することが期待される。
同グループは、汎用性の高いスパッタ法を用いて、結晶成長が困難とされていた窒化スカンジウムアルミニウム(ScAlN)薄膜を高品質で作製することに成功。成長温度の上昇により表面平坦性が改善、特に750℃で成長させた薄膜が最も平坦かつ高品質であることを明らかにした。750℃で成長させた薄膜では、2次元電子ガス密度が約3倍に増加し、高性能デバイス応用への可能性が示された。
本研究成果をさらに発展させることで、次世代の高性能エレクトロニクス材料の開発を促進する知見となることが期待される。また、産業界で汎用されるスパッタ法を用いた薄膜作製技術は窒化物半導体材料全般に応用できる可能性を秘めており、エレクトロニクス分野全体にインパクトを与える重要な成果といえる。
本研究を主導した東京理科大学の小林 篤准教授は、「ScAlN薄膜の結晶成長は困難とされてきましたが、スパッタ法を用いて高品質な薄膜を作製することを目指し、半導体製造技術および材料科学における興味から本研究を進めてきました。この研究の成果により、高性能かつ環境に強い電子デバイスの普及が促進され、電力の効率的な利用を通じて、人々の生活の利便性と安全性が向上することが期待されます」と、コメントした。









