2025年06月04日 09:54
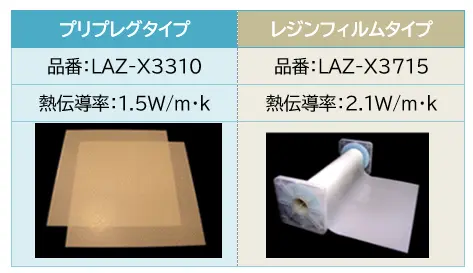
住友ベークライトは、半導体パッケージ向け基板材料「LαZ」の新製品として、半導体チップに生じた熱を効果的に放熱する高熱伝導基板材料を開発し、サンプルワークを開始した。
AIや5G、エッジコンピューティングに代表される先端半導体や出力容量の増加や高周波化が進むパワーデバイスは、チップの高集積化や小型化、伝送損失の低減、省電力化などが求められている。その解決策の1つとして、チップを基板に内蔵することでビア接続により配線距離を短くする検討がなされている。一方で、内蔵された半導体チップの発熱が製品にダメージを与え、エネルギー効率や製品のパフォーマンスを低下させる原因となるため、チップの発熱抑制や放熱が重要な課題となる。
内蔵されたチップの放熱は層間を接続するために使用される導電性のビアを用いたサーマルビアによるものが主流だったが、基板に高い熱伝導性を持たせることで放熱性が向上し、サーマルビア数の減少により回路設計の自由度が増し、部品の小型化にも貢献すると期待されている。
同社は、高い熱伝導率を持つ基板材料を開発。プリプレグタイプで1.5W、レジンフィルムタイプで2.1Wの熱伝導率を持ち、レジンフィルムタイプではチップ埋込用のキャビティを樹脂で埋め込むための高流動性も付与している。これにより、基板内部の放熱性が向上する。本製品は、プリプレグ材とレジンフィルム材でサンプルワークを開始し、2025年度中の量産化を目指す。









